
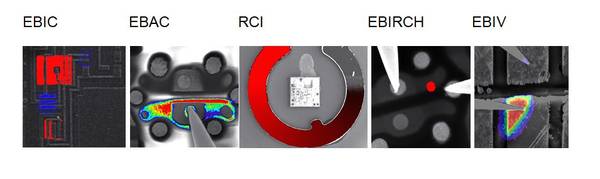
|
|
半導体の故障を検出するための強力かつシンプルなナノプロービング分析技術として、EBIC(Electron Beam Induced Current:電子ビーム誘起電流)があります。EBICおよびRCI、EBAC、EBIRCH、EBIVなどの関連手法は、電子ビームを使ってサンプル内に信号を発生させ、その信号を増幅して画像化します。 |
イメージ
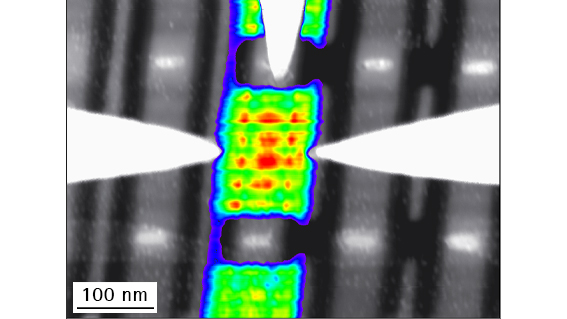 EBICデータとSE画像を重ね合わせ、 5nm FinFETトランジスタの各フィンを示す |
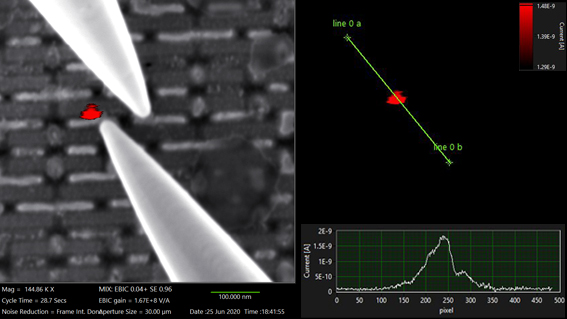 5nm FinFETトランジスタのEBIRCH結果 |
 EBIV(電子ビーム誘起電圧)のデータと 対応するSE画像の重ね合わせ |
 EBIVデータのラインスキャン解析 |
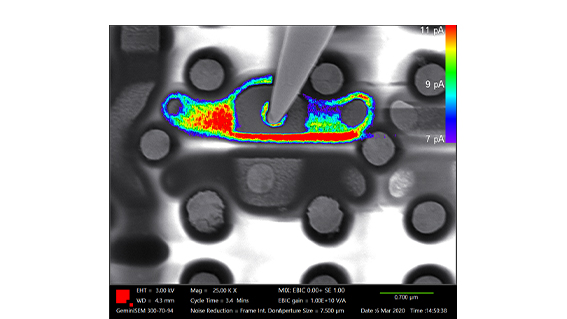 EBACデータと対応する SE画像の重ね合わせ |
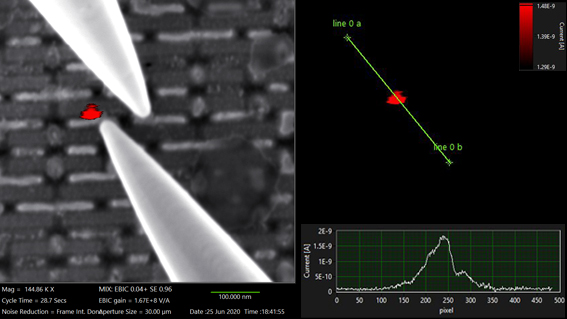 EBIRCHデータ(7nm)と対応する SE画像の重ね合わせとラインプロット |
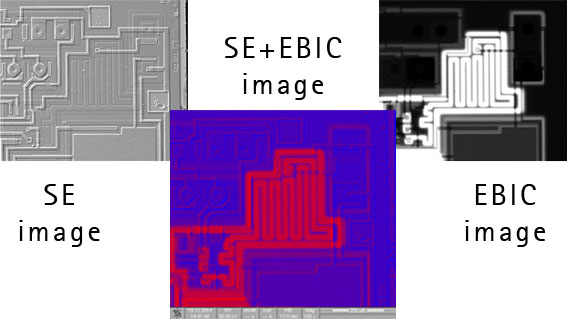 SE画像とEBIC画像の比較 および結果としての混合画像 |
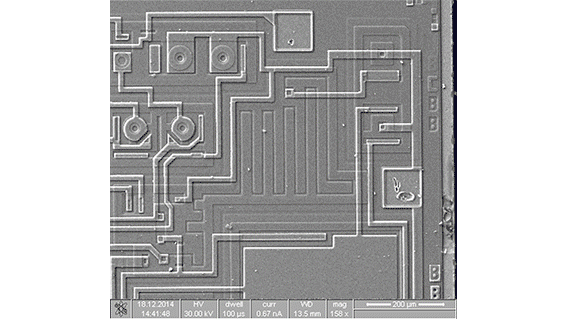 左図のアニメーション |
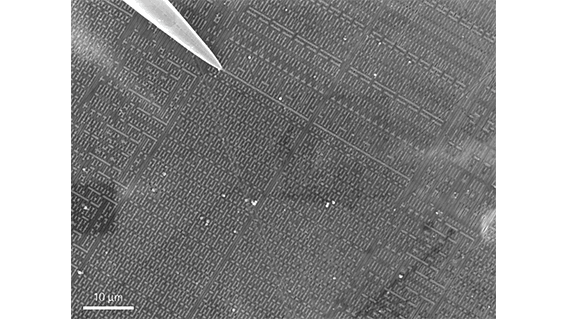
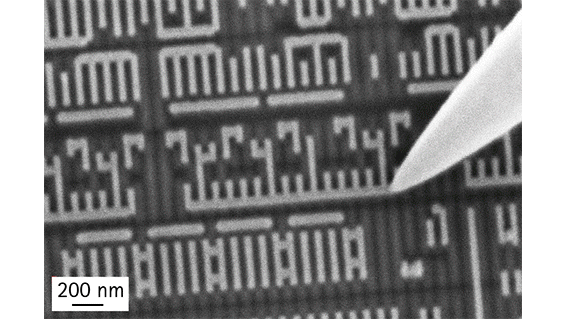 14nmチップにおけるEBICの結果 |
|
 22nmテクノロジーにおけるEBICの応答 |
 埋もれたラインを示すEBACの結果 |
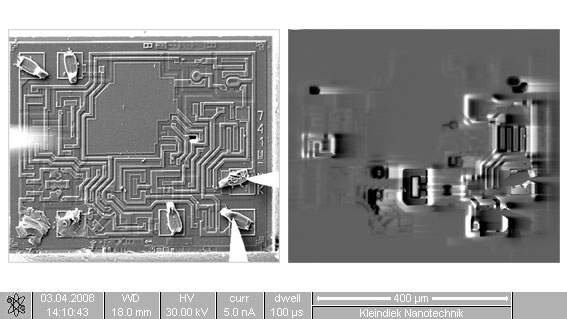 オペアンプ内のp-n接合のEBIC概要 |
|
紹介動画
|
[EBIC and EBAC result overlays] [Resistive Contrast Imaging (aka Electron Beam absorbed Current, EBAC)] |
Kleindiek社 <マイクロマニピュレータ・サブステージ>
▶ Kleindiek(クラインディーク)製品 トップページ





